从LED倒装到晶圆级封装
发布时间:2015-09-08 10:24 来源:修大屏 浏览次数:
什麽是晶圆级封装LED(Wafer Level Chip Scale Package LED,简称WLCSP LED,或WLP LED),简单说它是以倒装的方式应用、而晶片作为LED封装元件,并具备解决:机(机构)、电(电性)、热(导热)的功能,但他的封装是在整片外延片完成後再切割成一粒粒晶片,可直接上锡膏或共晶(共金)、导电胶等可做成CSP、DOB(COB)等各种封装方式。
与2009年前的倒装LED(覆晶LED,Flip Chip LED)有什麽不一样,就要从封装技术理论定义来説明如下:
一、封装的目的:
1.提供乘载与机构保护的功能,保护LED免於物理性质的破坏或化学物质的侵蚀。
2.提供能量的传递路径与晶片的讯号分布。
3.避免讯号延迟的产生,影响系统的运作。
4.提供散热的途径,增加晶片散热能力。
二、封装的技术层级区分:
1.第零层级封装(晶片层级界面接合) (简称L0):系指LED晶片上的电路设计与制造,又常称为晶片制程。
2.第一层级封装(单晶片或多晶片模组) (简称L1):系指将LED晶片黏结於一封装导线架中,并完成其中的机构密封保护(机)与电路连线(电)、导热(热)於导线架之制程,使晶片层级成为元件层级封装,又常称为封装制程。
3.第二层级封装(印刷电路板、PCB)(简称L2):系指将第一层级封装完成的元件组合於一电路板上的制程,又常称为模组(Module)或SMT制程。
4.第三层级封装(母板)(简称L3):系指将数个电路板组合於一主机板上使成为一次系统的制程,或将数个次系统组合成为一完整的电子产品,又常称为产品制程。
整理如下图:
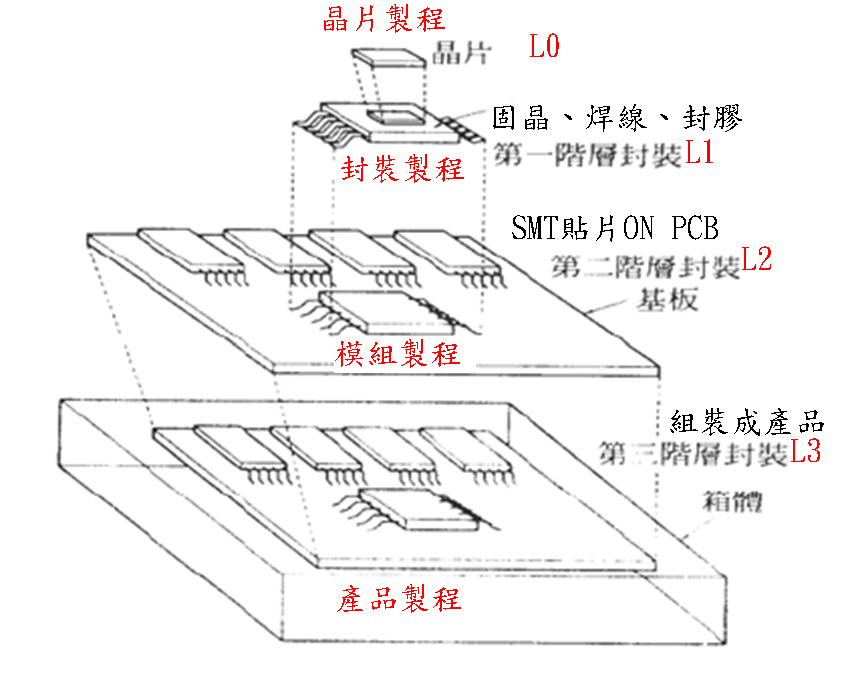
三、倒装LED(覆晶LED,Flip Chip LED,FC LED)技术:
倒装(覆晶FC)封装技术它约於1960年由美国IBM公司所开发,在Pad上沈积锡铅球,而後将晶片翻转、加热,使锡铅球软化再与基板相结合,它属於平列式(Area Array)的接合而非打线接合,Philips Lumileds最早引入LED高功率封装,在2009年以前的倒装LED(覆晶LED)特徵是有一转接板(substrate),专利几乎都是此技术。
四、晶圆层级封装LED(Wafer Level Chip Scale Package LED)技术:
所谓晶圆层级封装LED(WLCSP LED)乃是以直接在外延片(磊晶片)上达到直接积层的封装方式,也就是直接将整片外延片进行封装,所以晶圆级封装LED的晶片已是L1层级LED,亦称免封装LED因已直接做积层封装方式,然後切割成单颗LED晶片。
而倒装LED的晶片是L0层级,2010年以後LED界所使用的覆晶LED、倒装LED、Flip Chip led、FC led、免封装LED,指的就是这个晶圆层级封装LED(WLCSP LED)才是正确的名称。
WLCSP LED封装法拥有最短的讯号导线及能量的传递路径,具有下列优点:
1.以倒装的方式应用并具备晶片尺寸型封装(CSP)。
2. 薄型封装。
3. 封装成本较传统法低。
4. 可靠性(Reliability)高。
5. 散热性佳(热传导路径短)。
6. 电性优良(封装的走线短,使得电感及电容低)。
7. 可运用现有的SMT设备。
8. 组装上板快速等优点。
要分辨倒装LED(Flip Chip LED)舆晶圆级封装LED(WLCSP LED)的差别,除了前面提到可省去转接板(substrate)外,由前面封装的目的、封装的技术层级区分说明,传统倒装LED晶片是L0层级,而晶圆级封装LED的晶片是L1层级LED(晶圆级封装LED没有L0层级产品),晶片是L1层级同LED封装元件具备解决:机(机构)、电(电性)、热(导热)的功能,而传统倒装LED晶片是L0层级没有具备解决机、电、热的功能,必需再做L1才能具备解决机(机构)、电(电性)、热(导热)的功能。
所以2009年以前的倒装LED与2010以後的倒装LED是不一样的封装技术,在学理上正确名称是晶圆级封装LED(WLCSP LED)。
在专利实务上我们就以2005年到2014年馥珅光电在欧美、大陆、台湾、韩国、等国申请被审核20案左右晶圆级封装LED专利,依各国知识产权管理单位的实际核驳叙述説明:
1.Philips Lumileds:业界都知道倒装LED专利几乎都是Philips Lumileds所布局,我们在各国知识产权管理机构的核驳案,确实大部分倒装LED专利都是该公司的专利案,但没看到该公司的晶圆级封装LED专利案,2011我们曾送样给该集团,2014年该公司才生产晶圆级封装LED。
2.Cree:我们在各国知识产权管理机构的核驳案,该公司最早倒装LED专利是2007年的专利案。
3.OSRAM:我们在各国知识产权管理机构的核驳案,没遇到该公司的相关专利。
4.日亜(日本):我们在各国知识产权管理机构的核驳案,遇到该公司倒装LED专利更趋近於晶圆级封装LED的专利案但还不具备晶圆级封装LED的条件专利。
5.晶电(台湾):我们在各国知识产权管理机构的核驳案,没遇过该公司的倒装LED专利或晶圆级封装LED专利案,2009年初跟我们要了一些晶圆级封装LED专利资料。
6.新世纪(台湾):我们在各国知识产权管理机构的核驳案,没遇过该公司的倒装LED专利或晶圆级封装LED专利案,2007年中跟我们要了一些晶圆级封装LED专利资料。
7.SamSung(韩国):我们在韩国及各国知识产权管理机构的核驳案,没遇过该公司的倒装LED专利或晶圆级封装LED专利案,
以上是对上位层级L0、L1制程、结构专利讨论,也是馥珅光电这10年来专利申请的实际案例,当然这些主要LED厂是否有晶圆级封装LED专利,是可以排除大部分,小部分有可能各国知识产权管理机构没发现或解读不同。
当然原创晶圆级封装LED专利技术是馥珅光电的多位博士研发团队多年来的研发成果,WLCSP LED亮度比市售封装LED平均可高5%以上,将来依理论应可提高到20%,再则我们愿意在专利上、商业上舆同业合作或代工元件、DOB(COB)光源模组、欢迎有兴趣的上下游同业与我们接恰。
参考资料:
1、半导体电子元件构装技术---------田民波编着(北京)----五南书局(台湾)出版
2、IC封装制程与CAE应用--------锺文仁、陈佑任编着------全华图书公司(台湾)印行
3、半导体封装工程-大塚宽治、宇佐美保原着郭嘉龙编译-全华图书公司(台湾)印行
4、Introduction to Semiconductor Manufacturing Technology Hong Xiao着
半导体制程技术导论--罗正忠张鼎张译-------台湾培生教育出版股份有限公司出版
提炼亮点:
1、晶圆级封装LED没有L0层级产品及可省去转接板。
2、晶圆级封装LED晶片是L1层级、同LED封装元件具备解决:机(机构)、电(电性)、热(导热)的功能。
3、依各国知识产权管理机构实际核驳可看到,国际大厂的专利都是传统倒装LED晶片是L0层级,而不是晶圆级封装LED的晶片是L1层级LED。
4、现在的倒装LED名称应正名爲晶圆级封装 LED,原创晶圆级封装LED专利技术是馥珅光电的多位博士研发团队多年来的研发成果。

